A New Class of 3-D Wafer Build-up Pre-pregs
- Nano-filler with molecularly engineered stress-relief high Tg modified cyanate ester
- Engineered CTE to match copper or HDI core board for build-up flexibility
- Low moisture absorption and low dielectric constant for reliability and performance
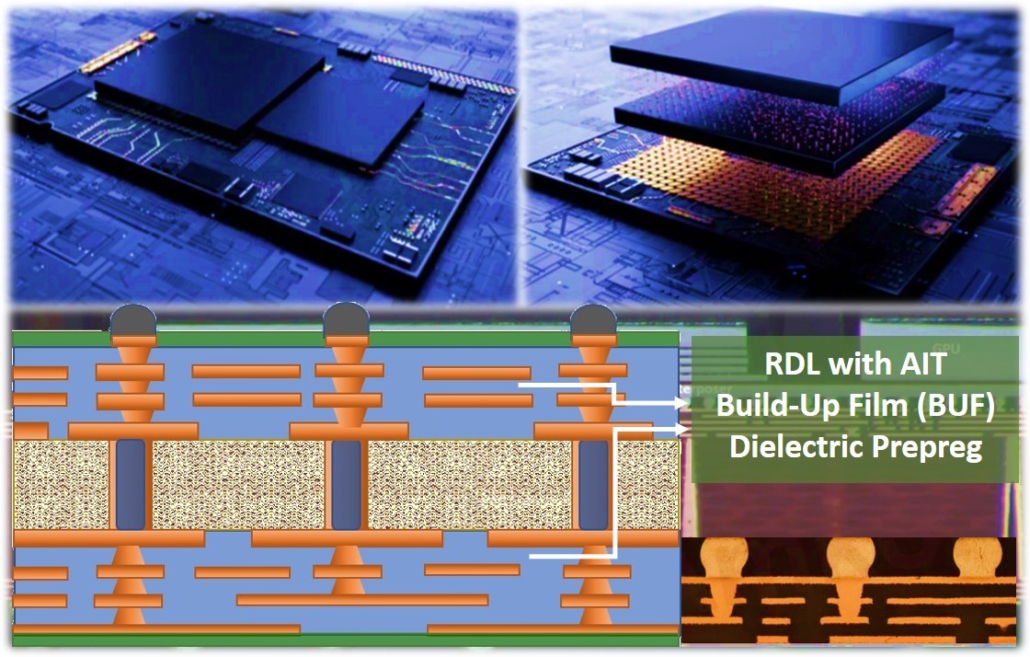
AIT Build-up Film Pre-pregs advancing 3-D heterogenous chip Integrations:
- AIT build-up film represents a new class of build-up film adhesive prepregs with nano-fillers (BUF-NP product line) to advance the micron-sized lines and micro-vias in the 3-D wafer heterogenous integration.
- BUF-FP build-up film prepreg lines with 10µm cut-off filler size is designed to supplement the current 3-D integration supply shortages.
- AIT has expanded its film production capability in two locations in United States while working on additional production capacity in China in meeting the buildup film shortage challenges.