从LAPTOP和TABLET到主机箱计算机、超级计算机和多核服务器及台式机的CPU、GPU、内存模块的DIE ATTACH和热敏接口材料
- 高功率CPU和GPU的高性能电热芯片附加装置
- 用于GPU模块的瞬间粘合压敏热敏胶带粘合剂
- 可压缩、可变形相变热界面材料(TIM)衬垫
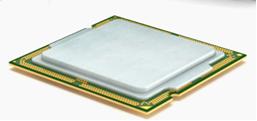
20多年来,已被证明是最低的模贴热阻模贴胶。
Die-Attach热管理是CPU和GPU模块中热堆栈的第一层,也是最关键的一层。高导热性与薄而无空隙的模贴胶的结合线是快速将热量散失到更广泛的模块基板上的关键。 AI Technology拥有超过20年的经验,在支持高性能超级计算机、大型计算机、服务器、台式机、笔记本电脑和平板电脑的高性能CPU和GPU模块方面,其高分子柔韧性和最低热阻的模片附着胶已经有超过20年的经验。
- ME8512是一种流行的无空隙模具附件,具有低电阻和热阻的特点。
- ME7519-LB为导热性和电绝缘模头胶。
- ME7159-CD和ME8456-DA一直以来都是大型芯片中对CPU和GPU绑定要求最高的工作母机。
- MC7885和MC8880适用于250°C以上的高功率应用。

|

可压缩的相变热接口片
- 可压缩和保形耦合相变,以消除空隙。
- 经过验证,适用于最严格的包括军事应用。
- 无硅氧烷和无污染
- 美国专利创新
| 用于极端功率GPU的散热接口材料 | ||
| 功能 | AI Technology部分# | 热、电和其他相关性能 |
| 可压缩相位变化 | COOL-SILVER™ 垫 CPR8850-LB |
|
| 可压缩相位变化 | COOL-SILVER™ G3垫 |
|
| 可压缩相位变化 | COOL-PAD™ CPR7159-LB |
|
| 可压缩相位变化 | COOL-PAD™ CPR7155-LB |
|
| 空隙填充热垫 | COOL-GAPFILL™ DT |
|
| 空隙填充热垫 | COOL-GAPFILL™ TT |
|
| 热凝胶 | COOL-SILVER™ G3凝胶 |
|

可压缩的热空隙垫热界面
- 可压缩和保形
- 适用于大面积热填充到不同部件的高度缝隙中的大面积热填充
- 适用于大面积模块到设备外壳的理想选择
- 经过验证,可用于最关键的热学挑战,具有军用级别的可靠性。
- 无硅氧烷和无污染
- 可提供不同厚度的单面或双面压敏的单面或两面压敏的产品。
功能更强大的图形处理器单元(GPU)模块的散热接口
- 瞬间粘接可压缩的压敏胶带和垫子。
- 可压缩的相位变化接口垫,经过性能验证的可压缩相位变化接口垫
| GPU和其他模块安装热敏胶 | |||
| 属性/参数 | RTC8550 | RTK 7559-LB | ME 7159-LB |
| 介电强度(伏特/密尔) | 不适用 | >750 | >750 |
| Device Push-off Strength (psi) | >1000 | >1000 | >1000 |
| 固化密度(克/cc) | 4.5 | 2.5 | 2.5 |
| Thermal Conductivity | > 8.0 W/m-°C | > 8.0 W/m-°C | > 12 W/m-°C |
| 最大连续工作温度(°C)(°C) | > 150 | > 150 | > 150 |
| Electrical Resistivity | <3×10-⁴ ohm-cm | >10¹⁴欧姆-cm | >10¹⁴欧姆-cm |

AI Technology的CPU、GPU和内存模块电子胶粘剂和热管理材料解决方案除了无与伦比的低热阻外,其独特之处在于它的长期可靠性。在芯片连接、模块安装和散热器热接口方面,其专利的可压缩相变接口垫,以及经过多年的热冲击和循环使用的分子柔性结构的内置应力消除,其长期的可靠性和稳定的性能,是公司成立以来产品的基石。
|

热界面材料性能的比较。较低的温升代表了热界面材料将功率电子器件产生的热量传递给通过强制循环空气向环境散热的散热片(带风扇)的效率的测量。热界面材料的厚度对散热效率也有很大的影响,应在物理结构或结构允许的范围内尽量减少热界面材料的厚度。特定的热界面材料的有效性不能通过宣称的甚至是测量的散装导热系数数据或值来轻易地预测:热界面材料在其各自的界面上对基体的热阻对于较薄的结合线或界面厚度的热界面材料的热阻是显著的,代表着 "耦合效率",是无法预测的,必须通过测量来实现。
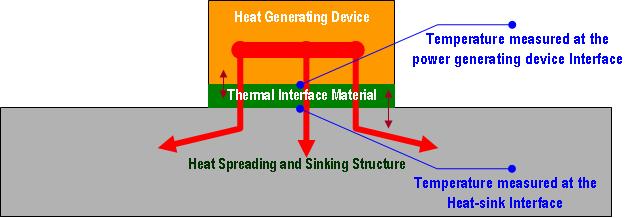
热界面材料比较中的数据是通过使用上述配置中的Intel CPU和强制空气散热器来采集的。在散热器与热界面材料的接口处钻孔并嵌入一个热电偶,以提供接口处的直接温度数据,用于测量特定热界面材料与散热器的 "耦合"。
如需了解更多关于模组可靠性管理和模块热接口管理的信息和建议帮助,请联系AI Technology销售和工程部。
AI Technology技术销售和服务部门也可以通过以下方式联系:1-609-799-9388或1-800-735-5040 (美国东部时间)和传真:609-799-9308。1-609-799-9388或1-800-735-5040(美国东部时间)和传真:609-799-9308